SMT usa análise e solución de cavidades de soldadura por refluxo de aire en pasta de soldador convencional (Edición Essence 2023), ¡mereces iso!
1 Introdución

No ensamblaxe da placa de circuíto, primeiro imprímese pasta de soldadura na almofada de soldadura da placa de circuíto e, a continuación, fíxanse varios compoñentes electrónicos. Finalmente, despois do forno de refluxo, as perlas de estaño da pasta de soldadura fúndense e todo tipo de compoñentes electrónicos e a almofada de soldadura da placa de circuíto soldanse para realizar o ensamblaxe de submódulos eléctricos. A tecnoloxía de montaxe superficial (SMT) úsase cada vez máis en produtos de envasado de alta densidade, como encapsulados a nivel de sistema (SiP), dispositivos Ballgridarray (BGA) e dispositivos Power Bare Chip, encapsulados cadrados planos sen pines (Quad AATNo-Lead, coñecidos como QFN).
Debido ás características do proceso e dos materiais de soldadura por pasta de soldadura, despois da soldadura por refluxo destes dispositivos de gran superficie de soldadura, haberá buratos na área de soldadura, o que afectará as propiedades eléctricas, térmicas e mecánicas do rendemento do produto, e mesmo levará a un fallo do produto. Polo tanto, mellorar a cavidade de soldadura por refluxo da pasta de soldadura converteuse nun problema técnico e de proceso que debe resolverse. Algúns investigadores analizaron e estudaron as causas da cavidade de soldadura de bólas de soldadura BGA e proporcionaron solucións de mellora. Falta unha solución de chip espido para a área de soldadura do proceso convencional de soldadura por refluxo de pasta de soldadura de QFN superior a 10 mm2 ou unha área de soldadura superior a 6 mm2.
Emprega a soldadura preformada e a soldadura en forno de refluxo ao baleiro para mellorar o orificio de soldadura. A soldadura prefabricada require un equipo especial para apuntar o fluxo. Por exemplo, o chip desprázase e inclínase considerablemente despois de colocalo directamente sobre a soldadura prefabricada. Se o chip de montaxe de fluxo se refloa e logo se apunta, o proceso aumenta en dúas refloas, e o custo da soldadura prefabricada e do material de fluxo é moito maior que o da pasta de soldadura.
Os equipos de refluxo ao baleiro son máis caros, a capacidade de baleiro da cámara de baleiro independente é moi baixa, o rendemento de custos non é alto e o problema das salpicaduras de estaño é grave, o que é un factor importante na aplicación de produtos de alta densidade e paso pequeno. Neste artigo, baseado no proceso convencional de soldadura por refluxo de pasta de soldador, desenvólvese e introdúcese un novo proceso de soldadura por refluxo secundario para mellorar a cavidade de soldadura e resolver os problemas de unión e rachaduras do selo plástico causados pola cavidade de soldadura.
2 Cavidade de soldadura por refluxo para impresión en pasta de soldadura e mecanismo de produción
2.1 Cavidade de soldadura
Despois da soldadura por refluxo, o produto foi probado con raios X. Descubriuse que os buratos na zona de soldadura con cor máis clara se debían a unha soldadura insuficiente na capa de soldadura, como se mostra na Figura 1.
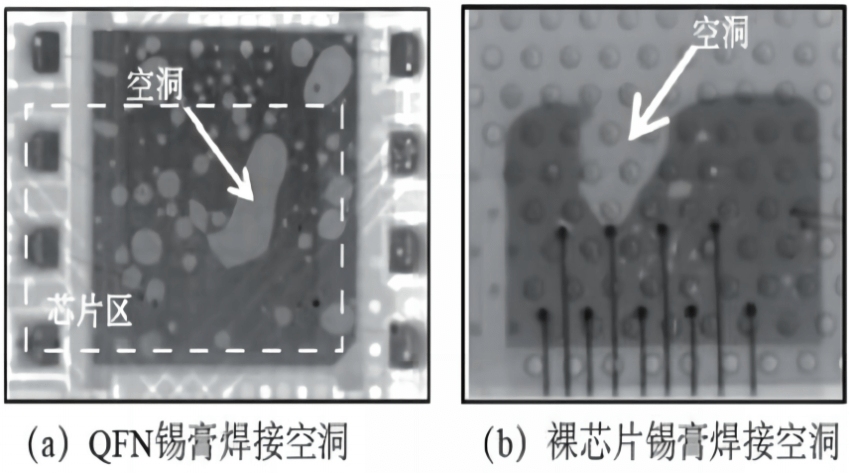
Detección por raios X do burato da burbulla
2.2 Mecanismo de formación da cavidade de soldadura
Tomando como exemplo a pasta de soldar sAC305, a composición e a función principais móstranse na Táboa 1. As perlas de fundente e estaño únense en forma de pasta. A proporción en peso de soldadura de estaño con respecto ao fundente é de aproximadamente 9:1 e a proporción en volume é de aproximadamente 1:1.

Despois de imprimir e montar a pasta de soldadura con varios compoñentes electrónicos, esta pasará por catro etapas de prequecemento, activación, refluxo e arrefriamento ao pasar polo forno de refluxo. O estado da pasta de soldadura tamén difire con diferentes temperaturas nas diferentes etapas, como se mostra na Figura 2.
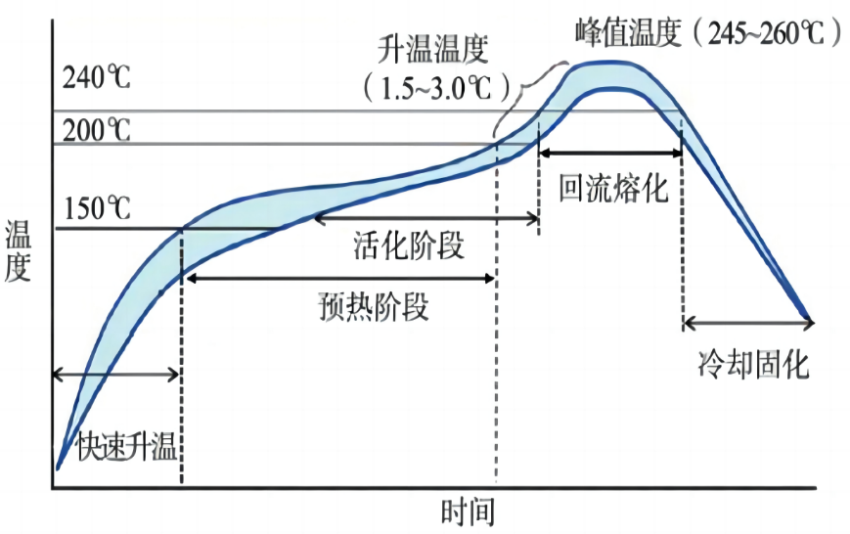
Referencia de perfil para cada área de soldadura por refluxo
Na etapa de prequecemento e activación, os compoñentes volátiles do fluxo na pasta de soldadura volatilízanse a gas ao quentalos. Ao mesmo tempo, produciranse gases cando se retire o óxido da superficie da capa de soldadura. Algúns destes gases volatilízanse e abandonan a pasta de soldadura, e as perlas de soldadura condénsanse fortemente debido á volatilización do fluxo. Na etapa de refluxo, o fluxo restante na pasta de soldadura evaporarase rapidamente, as perlas de estaño fundiranse, unha pequena cantidade de gas volátil de fluxo e a maior parte do aire entre as perlas de estaño non se dispersarán a tempo, e os residuos no estaño fundido e baixo a tensión do estaño fundido forman unha estrutura de sándwich de hamburguesa e son atrapados pola almofada de soldadura da placa de circuíto e os compoñentes electrónicos, e o gas envolto no estaño líquido é difícil de escapar só pola flotabilidade ascendente. O tempo de fusión superior é moi curto. Cando o estaño fundido arrefría e se converte en estaño sólido, aparecen poros na capa de soldadura e fórmanse buratos de soldadura, como se mostra na Figura 3.
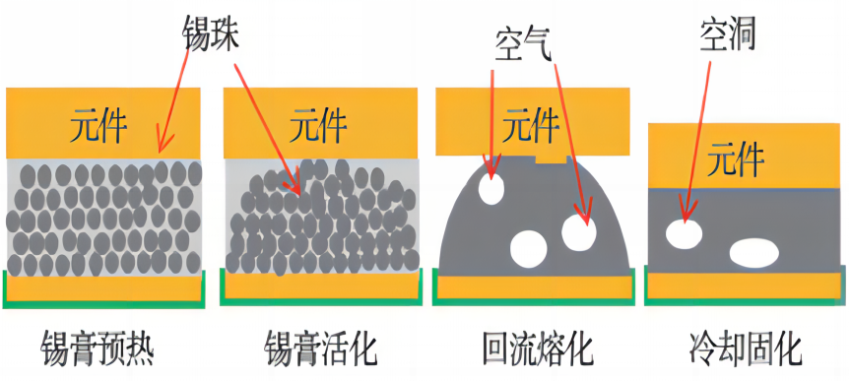
Diagrama esquemático do baleiro xerado pola soldadura por refluxo con pasta de soldadura
A causa principal da formación de cavidades para a soldadura é que o aire ou o gas volátil envolto na pasta de soldadura despois da fusión non se descarga completamente. Os factores que inflúen inclúen o material da pasta de soldadura, a forma da impresión da pasta de soldadura, a cantidade de impresión da pasta de soldadura, a temperatura de refluxo, o tempo de refluxo, o tamaño da soldadura, a estrutura, etc.
3. Verificación dos factores que inflúen na impresión de pasta de soldadura por refluxo de orificios de soldadura
Utilizáronse probas de QFN e de chip espido para confirmar as principais causas dos ocos da soldadura por refluxo e para atopar xeitos de mellorar os ocos da soldadura por refluxo impresos con pasta de soldadura. O perfil do produto de soldadura por refluxo de QFN e de chip espido móstrase na Figura 4, o tamaño da superficie de soldadura QFN é de 4,4 mm x 4,1 mm, a superficie de soldadura é unha capa estañada (100 % de estaño puro); o tamaño da soldadura do chip espido é de 3,0 mm x 2,3 mm, a capa de soldadura é unha capa bimetálica de níquel-vanadio pulverizada e a capa superficial é de vanadio. A almofada de soldadura do substrato foi de níquel-paladio por inmersión en ouro electrolítico e o grosor foi de 0,4 μm/0,06 μm/0,04 μm. Úsase pasta de soldadura SAC305, o equipo de impresión de pasta de soldadura é DEK Horizon APix, o equipo de forno de refluxo é BTUPyramax150N e o equipo de raios X é DAGExD7500VR.
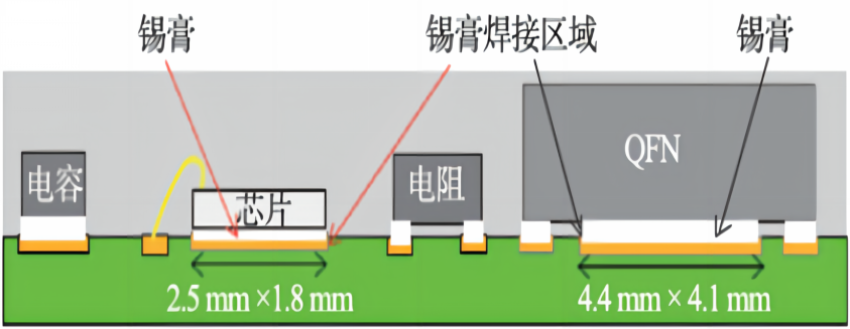
Debuxos de soldadura QFN e de viruta espida
Para facilitar a comparación dos resultados das probas, realizouse a soldadura por refluxo nas condicións da Táboa 2.

Táboa de condicións de soldadura por refluxo
Despois de completar a montaxe superficial e a soldadura por refluxo, detectouse a capa de soldadura mediante raios X e comprobouse que había grandes buratos na capa de soldadura na parte inferior do QFN e na lasca espida, como se mostra na Figura 5.
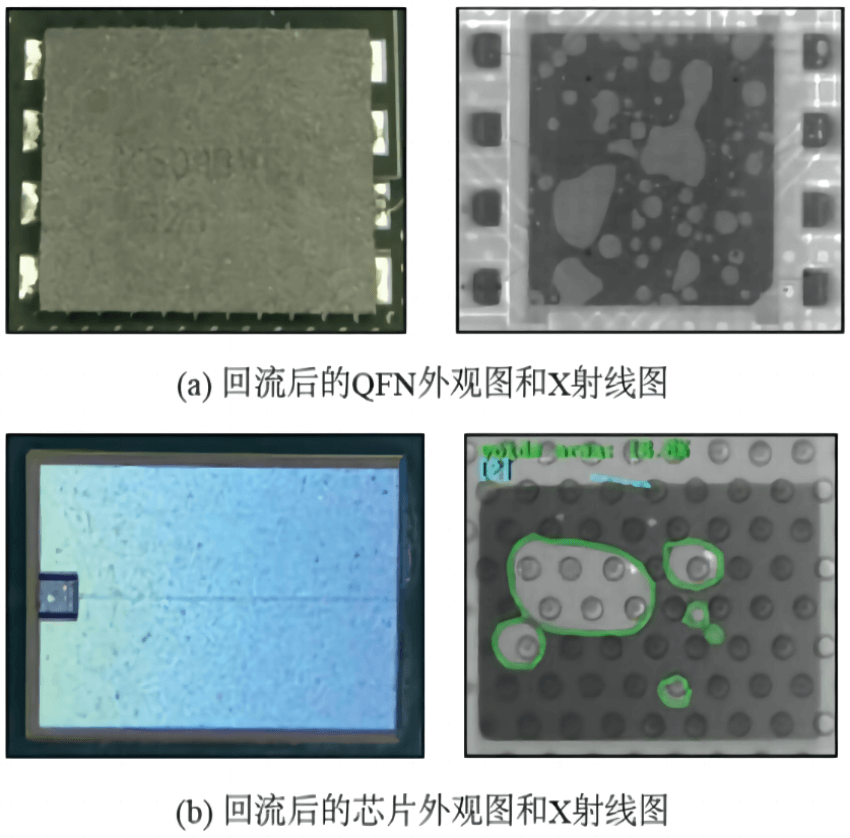
QFN e holograma de chip (raios X)
Dado que o tamaño do cordón de estaño, o grosor da malla de aceiro, a taxa de área de abertura, a forma da malla de aceiro, o tempo de refluxo e a temperatura máxima do forno afectarán os ocos da soldadura por refluxo, existen moitos factores de influencia que se verificarán directamente mediante a proba DOE, e o número de grupos experimentais será demasiado grande. É necesario cribar e determinar rapidamente os principais factores de influencia mediante a proba de comparación de correlación e, a continuación, optimizar aínda máis os principais factores de influencia mediante DOE.
3.1 Dimensións dos orificios de soldadura e das perlas de estaño da pasta de soldadura
Coa proba de pasta de soldadura SAC305 de tipo 3 (tamaño de cordón 25-45 μm), as outras condicións permanecen inalteradas. Despois da reflución, mídense os buratos na capa de soldadura e compáranse coa pasta de soldadura de tipo 4. Obsérvase que os buratos na capa de soldadura non son significativamente diferentes entre os dous tipos de pasta de soldadura, o que indica que a pasta de soldadura con diferente tamaño de cordón non ten unha influencia obvia nos buratos da capa de soldadura, o que non é un factor de influencia, como se mostra na figura 6.

Comparación de buratos de po de estaño metálico con diferentes tamaños de partícula
3.2 Espesor da cavidade de soldadura e da malla de aceiro impresa
Despois da reflución, mediuse a área da cavidade da capa soldada coa malla de aceiro impresa cun grosor de 50 μm, 100 μm e 125 μm, e as demais condicións permaneceron sen cambios. Descubriuse que o efecto dos diferentes grosores da malla de aceiro (pasta de soldadura) na QFN comparouse co da malla de aceiro impresa cun grosor de 75 μm. A medida que o grosor da malla de aceiro aumenta, a área da cavidade diminúe gradualmente. Despois de alcanzar un certo grosor (100 μm), a área da cavidade inverterase e comezará a aumentar co aumento do grosor da malla de aceiro, como se mostra na Figura 7.
Isto demostra que cando se aumenta a cantidade de pasta de soldadura, o estaño líquido con refluxo queda cuberto polo chip e a saída de escape de aire residual só é estreita en catro lados. Cando se cambia a cantidade de pasta de soldadura, a saída de escape de aire residual tamén aumenta e a explosión instantánea de aire envolto no estaño líquido ou no gas volátil que escapa do estaño líquido fará que o estaño líquido salpique arredor do QFN e do chip.
A proba descubriu que co aumento do grosor da malla de aceiro, o estalido de burbullas causado pola fuga de aire ou gas volátil tamén aumenta, e a probabilidade de salpicaduras de estaño arredor do QFN e a lasca tamén aumenta en consecuencia.

Comparación de buratos en malla de aceiro de diferente grosor
3.3 Relación de área da cavidade de soldadura e a abertura da malla de aceiro
Probouse a malla de aceiro impresa cunha taxa de apertura do 100 %, 90 % e 80 %, e as demais condicións permaneceron sen cambios. Despois da reflución, mediuse a área da cavidade da capa soldada e comparouse coa malla de aceiro impresa cunha taxa de apertura do 100 %. Descubriuse que non había diferenzas significativas na cavidade da capa soldada nas condicións de taxa de apertura do 100 % e do 90 % ao 80 %, como se mostra na Figura 8.

Comparación de cavidades de diferentes áreas de abertura de diferentes mallas de aceiro
3.4 Cavidade soldada e forma de malla de aceiro impresa
Coa proba de forma de impresión da pasta de soldadura da tira b e da grella inclinada c, as outras condicións permanecen inalteradas. Despois da reflución, mídese a área da cavidade da capa de soldadura e compárase coa forma de impresión da grella a. Obsérvase que non hai diferenzas significativas na cavidade da capa de soldadura nas condicións de grella, tira e grella inclinada, como se mostra na Figura 9.
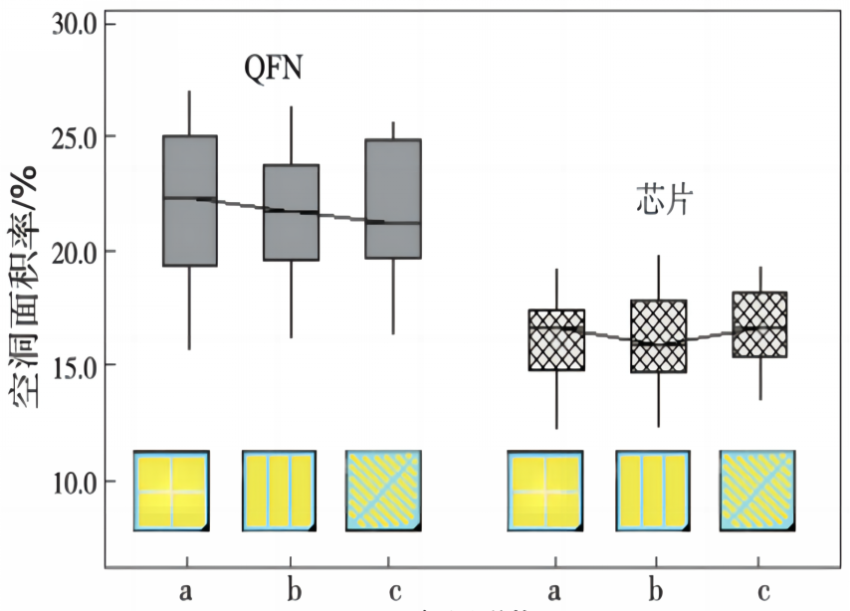
Comparación de buratos en diferentes modos de apertura de malla de aceiro
3.5 Cavidade de soldadura e tempo de refluxo
Tras unha proba de tempo de refluxo prolongada (70 s, 80 s, 90 s), as outras condicións permanecen sen cambios. O burato na capa de soldadura mediuse despois do refluxo e, en comparación co tempo de refluxo de 60 s, descubriuse que, co aumento do tempo de refluxo, a área do burato de soldadura diminuía, pero a amplitude de redución diminuía gradualmente co aumento do tempo, como se mostra na Figura 10. Isto demostra que, no caso dun tempo de refluxo insuficiente, aumentar o tempo de refluxo propicia o desbordamento completo do aire envolto no estaño líquido fundido, pero despois de que o tempo de refluxo aumente ata un certo tempo, é difícil que o aire envolto no estaño líquido volva desbordarse. O tempo de refluxo é un dos factores que afectan á cavidade de soldadura.

Comparación de baleiros de diferentes duracións de tempo de refluxo
3.6 Cavidade de soldadura e temperatura máxima do forno
Con probas de temperatura máxima do forno de 240 ℃ e 250 ℃ e outras condicións sen cambios, mediuse a área da cavidade da capa soldada despois da reflución e, comparada coa temperatura máxima do forno de 260 ℃, descubriuse que, en diferentes condicións de temperatura máxima do forno, a cavidade da capa soldada de QFN e o chip non cambiou significativamente, como se mostra na Figura 11. Mostra que as diferentes temperaturas máximas do forno non teñen un efecto obvio sobre o QFN e o burato na capa de soldadura do chip, o que non é un factor de influencia.

Comparación baleira de diferentes temperaturas máximas
As probas anteriores indican que os factores significativos que afectan a cavidade da capa de soldadura de QFN e a lasca son o tempo de refluxo e o grosor da malla de aceiro.
4 Mellora da cavidade de soldadura por refluxo para impresión en pasta de soldador
Proba 4.1DOE para mellorar a cavidade de soldadura
O burato na capa de soldadura de QFN e chip mellorouse atopando o valor óptimo dos principais factores de influencia (tempo de refluxo e grosor da malla de aceiro). A pasta de soldadura foi SAC305 tipo 4, a forma da malla de aceiro foi de tipo grella (100 % de grao de apertura), a temperatura máxima do forno foi de 260 ℃ e as outras condicións de proba foron as mesmas que as do equipo de proba. A proba DOE e os resultados móstranse na Táboa 3. As influencias do grosor da malla de aceiro e o tempo de refluxo nos buratos de soldadura de QFN e chip móstranse na Figura 12. Mediante a análise de interacción dos principais factores de influencia, observouse que o uso dun grosor de malla de aceiro de 100 μm e un tempo de refluxo de 80 s pode reducir significativamente a cavidade de soldadura de QFN e chip. A taxa de cavidade de soldadura de QFN redúcese do 27,8 % máximo ao 16,1 %, e a taxa de cavidade de soldadura de chip redúcese do 20,5 % máximo ao 14,5 %.
Na proba, producíronse 1000 produtos en condicións óptimas (100 μm de grosor de malla de aceiro, 80 s de tempo de refluxo) e a taxa de cavidade de soldadura de 100 QFN e chip mediuse aleatoriamente. A taxa media de cavidade de soldadura de QFN foi do 16,4 % e a taxa media de cavidade de soldadura do chip foi do 14,7 %. A taxa de cavidade de soldadura do chip e do chip redúcese obviamente.

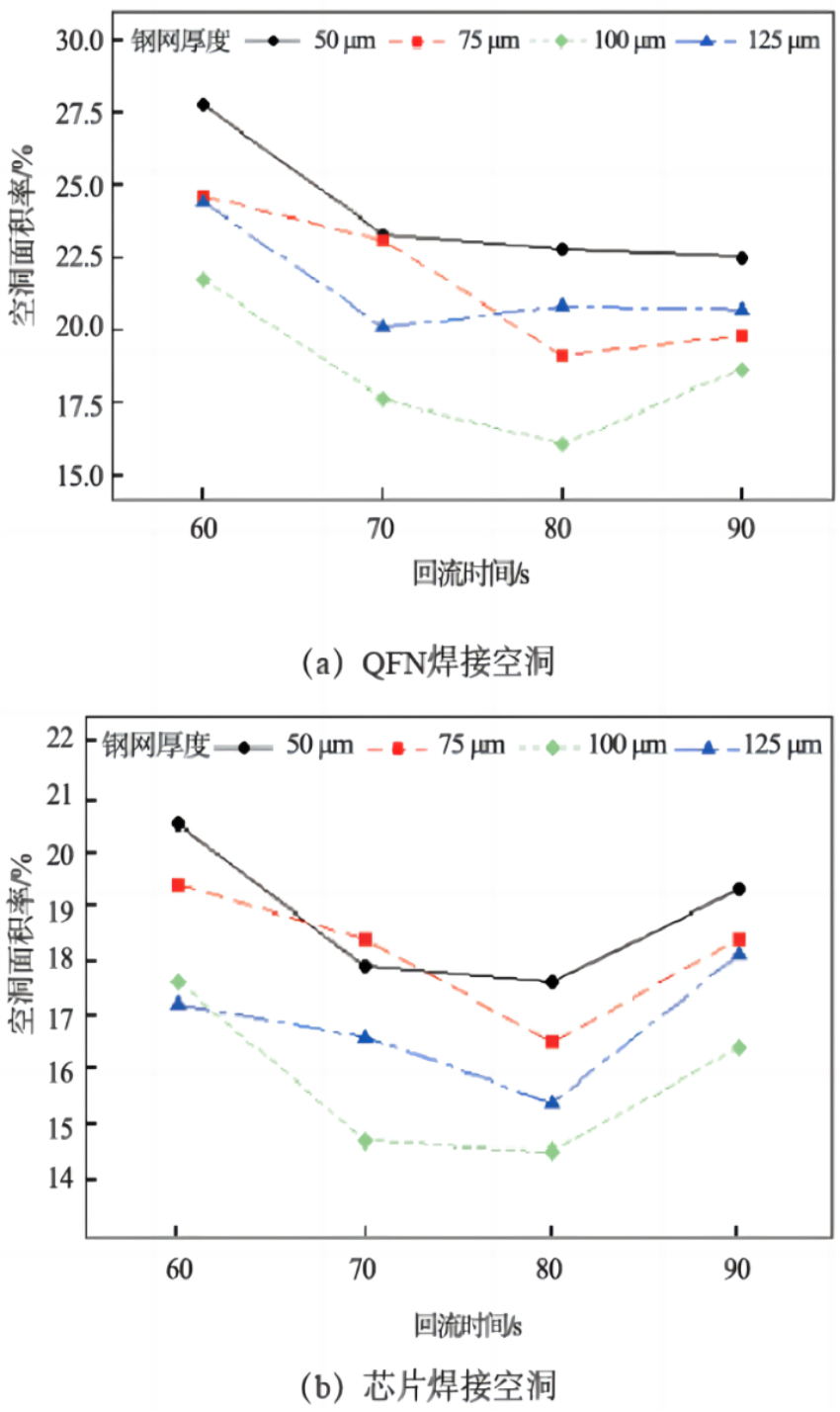
4.2 O novo proceso mellora a cavidade de soldadura
A situación real de produción e as probas amosan que cando a área da cavidade de soldadura na parte inferior do chip é inferior ao 10 %, o problema de fendas na posición da cavidade do chip non se producirá durante a unión e o moldeo do chumbo. Os parámetros do proceso optimizados por DOE non poden cumprir os requisitos de análise e resolución dos buratos na soldadura por refluxo de pasta de soldadura convencional, e a taxa de área da cavidade de soldadura do chip debe reducirse aínda máis.
Dado que o chip cuberto pola soldadura impide que o gas da soldadura escape, a taxa de buratos na parte inferior do chip redúcese aínda máis ao eliminar ou reducir o gas revestido da soldadura. Adóptase un novo proceso de soldadura por refluxo con dúas impresións de pasta de soldadura: unha impresión de pasta de soldadura, unha refluxo que non cobre QFN e o chip espido descarga o gas na soldadura; O proceso específico de impresión secundaria de pasta de soldadura, parche e refluxo secundario móstrase na Figura 13.
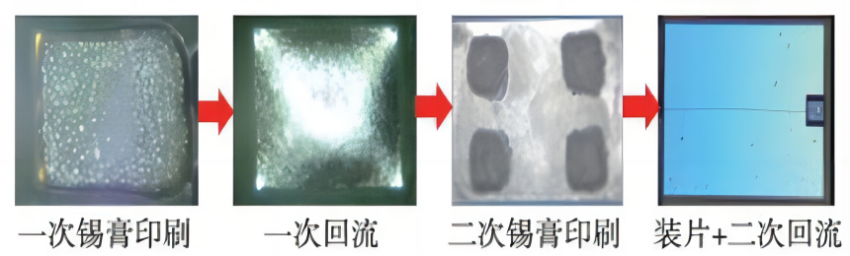
Cando se imprime por primeira vez pasta de soldadura de 75 μm de grosor, a maior parte do gas da soldadura sen cuberta do chip escapa da superficie e o grosor despois do refluxo é duns 50 μm. Despois de completar o refluxo primario, imprímense pequenos cadrados na superficie da soldadura solidificada arrefriada (para reducir a cantidade de pasta de soldadura, reducir a cantidade de derrame de gas, reducir ou eliminar as salpicaduras de soldadura) e a pasta de soldadura cun grosor de 50 μm (os resultados da proba anterior mostran que 100 μm é o mellor, polo que o grosor da impresión secundaria é de 100 μm. 50 μm = 50 μm), logo instálase o chip e logo volve durante 80 s. Case non hai burato na soldadura despois da primeira impresión e refluxo, e a pasta de soldadura na segunda impresión é pequena e o burato de soldadura é pequeno, como se mostra na Figura 14.
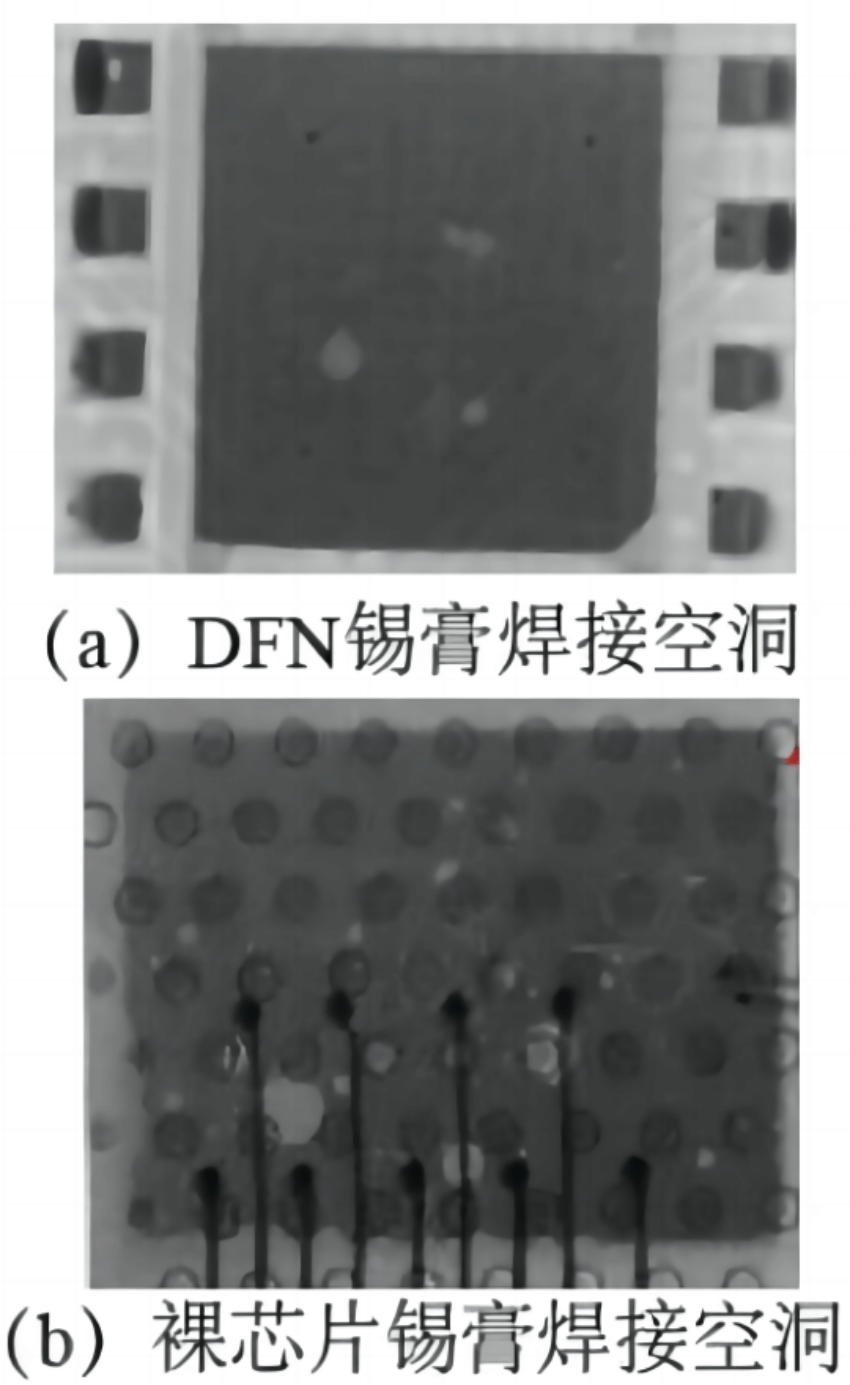
Despois de dúas impresións de pasta de soldadura, debuxo oco
4.3 Verificación do efecto da cavidade de soldadura
Produción de 2000 produtos (o grosor da primeira malla de aceiro de impresión é de 75 μm, o grosor da segunda malla de aceiro de impresión é de 50 μm), outras condicións sen cambios, medición aleatoria de 500 QFN e taxa de cavidade de soldadura de chip, descubriuse que o novo proceso despois do primeiro refluxo non houbo cavidade, despois do segundo QFN de refluxo a taxa máxima de cavidade de soldadura é do 4,8 % e a taxa máxima de cavidade de soldadura do chip é do 4,1 %. En comparación co proceso de soldadura de impresión dunha soa pasta orixinal e o proceso optimizado por DOE, a cavidade de soldadura redúcese significativamente, como se mostra na Figura 15. Non se atoparon gretas de chip despois das probas funcionais de todos os produtos.

5 Resumo
A optimización da cantidade de impresión en pasta de soldador e do tempo de refluxo pode reducir a área da cavidade de soldadura, pero a taxa da cavidade de soldadura segue sendo grande. O uso de dúas técnicas de soldadura por refluxo para impresión en pasta de soldador pode maximizar de forma eficaz a taxa da cavidade de soldadura. A área de soldadura do chip espido do circuíto QFN pode ser de 4,4 mm x 4,1 mm e 3,0 mm x 2,3 mm respectivamente na produción en masa. A taxa da cavidade da soldadura por refluxo contrólase por debaixo do 5 %, o que mellora a calidade e a fiabilidade da soldadura por refluxo. A investigación deste artigo proporciona unha referencia importante para mellorar o problema da cavidade de soldadura en superficies de soldadura de gran área.






